삼성전자가 업계 최초로 ’12단 3D-TSV(3차원 실리콘 관통전극, 3D Through Silicon Via)’ 기술을 개발하고 패키징 기술에서도 초격차를 이어간다.
’12단 3D-TSV’는 기존 금선(와이어)을 이용해 칩을 연결하는 대신 반도체 칩 상단과 하단에 머리카락 굵기의 20분의 1수준인 수 마이크로미터 직경의 전자 이동 통로(TSV) 6만개를 만들어 오차 없이 연결하는 첨단 패키징 기술이다.
이 기술은 종이(100㎛)의 절반 이하 두께로 가공한 D램 칩 12개를 적층해 수직으로 연결하는 고도의 정밀성이 필요해 반도체 패키징 기술 중 가장 난이도가 높은 기술이다. ‘3D-TSV’는 기존 와이어 본딩(Wire Bonding) 기술보다 칩들 간 신호를 주고받는 시간이 짧아져 속도와 소비전력을 획기적으로 개선할 수 있는 점이 특징이다.
삼성전자는 기존 8단 적층 HBM2 제품과 동일한 패키지 두께(720㎛, 업계 표준)를 유지하면서도 12개의 D램 칩을 적층해 고객들은 별도의 시스템 디자인 변경 없이 보다 높은 성능의 차세대 고용량 제품을 출시할 수 있게 됐다.
또한 고대역폭 메모리에 ’12단 3D-TSV’ 기술을 적용해 기존 8단에서 12단으로 높임으로써 용량을 1.5배 증가시킬 수 있다.
이 기술에 최신 16Gb D램 칩을 적용하면 업계 최대 용량인 24GB HBM(고대역폭 메모리, High Bandwidth Memory) 제품도 구현할 수 있다. 이는 현재 주력으로 양산 중인 8단 8GB 제품보다 3배 늘어난 용량이다.
※ 8GB 양산 제품 : 8Gb x 8단 / 24GB 개발 제품 : 16Gb x 12단
삼성전자 DS부문 TSP총괄 백홍주 부사장은 “인공지능, 자율주행, HPC(High-Performance Computing) 등 다양한 응용처에서 고성능을 구현할 수 있는 최첨단 패키징 기술이 날로 중요해지고 있다”라며, “기술의 한계를 극복한 혁신적인 ’12단 3D-TSV 기술’로 반도체 패키징 분야에서도 초격차 기술 리더십을 이어가겠다”라고 말했다.
삼성전자는 고객 수요에 맞춰 ’12단 3D-TSV’ 기술을 적용한 고용량 HBM 제품을 적기에 공급해 프리미엄 반도체 시장을 지속 선도해 나갈 계획이다.

▲ ‘3D-TSV’와 ‘와이어 본딩’ 비교 이미지

보도 -삼성전자






































![[All Around AI 1편] AI의 시작과 발전 과정, 미래 전망 우리 삶을 혁신적으로 바꾸고 있는 인공지능(Artificial Intelligence, AI). AI를 알고, 이해하고 또 활용하고 싶은 이들을 위해 <AAA - All Around AI>에서 AI 기술에 대한 모든 것을 알려드립니다. 1화에서는 인공...](https://raptor-hw.net/xe/files/thumbnails/198/205/241x165.crop.jpg)





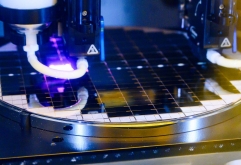
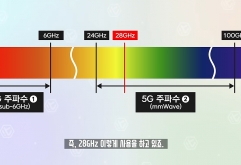






![[All Around AI 1편] AI의 시작과 발전 과 [All Around AI 1편] AI의 시작과 발전 과 by 인공지능](https://raptor-hw.net/xe/files/thumbnails/198/205/262x75.crop.jpg)











